二維材料的面內(nèi)-面外聯(lián)動解決方案 | 掠入射x射線衍射分析單層和超薄WS2薄膜(XRD)
布魯克X射線部門 孟璐
介紹
薄膜器件的功能高度依賴于其結(jié)構特性。X射線衍射(XRD)和x射線反射法(XRR)是研究薄膜的無損檢測技術,。檢測信號反饋了結(jié)構特性,,如膜層厚度,、界面粗糙度和電子密度,以及亞納米精度的晶體特性,。
當薄膜厚度在單層范圍內(nèi)時,,使用實驗室x射線衍射儀研究這些薄膜尤其具有挑戰(zhàn)性,需要應用掠入射技術從薄膜中獲得信號,。WS2是下一代二維電子器件中很有前途的候選者,。其高載流子遷移率和與厚度相關的光學帶隙使其適用于晶體管和其他半導體應用。
WS2也是光伏應用的理想材料,,因為基于WS2的太陽能電池具有較優(yōu)的太陽能轉(zhuǎn)換帶隙,,可以實現(xiàn)高效率??刂瞥S2薄膜的厚度和結(jié)構性能是實現(xiàn)其功能的關鍵,。
在本應用報告中,基于XRR和XRD表征,,研究了共面和非共面掠入射幾何形狀下單層(single monolayer)和十層(10 monolayers)兩個超薄WS2膜,。
實驗細節(jié)
數(shù)據(jù)采集使用D8 DISCOVER PlusTM衍射儀(圖1),配有工作電壓為40 kV和40 mA的銅靶,。該裝置硬件配置為聚焦格貝爾鏡,、中心歐拉環(huán)和LYNXEYE XE-T探測器(0D)。在面內(nèi)掠入射衍射(IP-GID)測量中,,在主,、次光束路徑上分別采用了軸向索拉(Soller)。Soller的角度接受度為0.5,,允許高透射率和合理的分辨率,,使它們非常適合測量弱散射信號。XRR測量在光管和探測器兩側(cè)使用0.2 mm狹縫進行,,以達到所需的角度分辨率,。

▲Figure 1 Instrumental setup for non-coplanar diffraction experiment
本研究調(diào)查了兩個樣本。在藍寶石襯底上由單層(sample #1)和名義上的10層(sample #2)WS2組成,。分別測量XRR,、GID和IP-GID。
對于IP-GID測量,,sample #1的2θ范圍為25°-160°,,sample #2的為10°-130°。每一步的測量時間約為100秒,,因此總測量時間約為17小時,。GID測量在5°-130°2θ范圍內(nèi)進行,每個角步積分50秒,,總測量時間約為9小時,。然而,,來自WS2膜的GID信號只在sample #2中觀察到。
為了得到WS膜的厚度,,進行了XRR測量,。對于10層膜(sample #2),在12分鐘內(nèi)測量了0°- 15°的2θ范圍,,步長為0.01°。對于sample #1,,XRR曲線2θ延升測試到30°,。對于兩個樣品,除了測量漫射散射背景外,,還測量了真實的鏡面XRR信號,。圖3和圖4描述了各自的測量結(jié)果。
結(jié)果和討論
通過使用DIFFRAC.TOPAS進行全剖面擬合來分析單層的IP-GID測量,。結(jié)果如圖2所示:采用c軸為零的空間群P63/mmc單相模擬WS2單層,。沒有觀測到(00l)反射分量,擬合可得面內(nèi)晶格常數(shù)為(a = 3.149 ?),。

▲Figure 2 IP-GID measurement of the WS2 monolayer along with DIFFRAC-TOPAS full profile fit
此外,,GID幾何結(jié)構中沒有任何反射(此處未顯示)證實了層的c軸缺失,因此WS2單層的片狀形態(tài),。通過XRR測量分析(圖3),,得到了~3.4 ?的薄膜厚度。為了解釋長振蕩,,必須在模型中加入一個電子密度較低的薄層,。

▲Figure 3 Analysis of XRR data from a single monolayer WS2 using DIFFRAC.XRR
對于樣品#2,XRR測量分析(圖4)顯示,,WS膜的厚度約為169.7 ?,。與WS單層一樣,在襯底處發(fā)現(xiàn)了一個電子密度降低的區(qū)域,。如果沒有擬合這個額外的區(qū)域,,兩條測量的XRR曲線都不能很好地擬合。

▲Figure 4 XRR analysis of sample#2 (nominal 10 monolayers of WS2) using DIFFRAC.XRR
GID測量的Pawley擬合(圖5)提供了a=3.084 ?和c=12.830 ?的晶格常數(shù),,并且~170 ?的厚度將對應大約13層WS2,。測量結(jié)果顯示(002)、(004)和(006)有取向性信號,,表明WS2薄膜(001)軸垂直于表面具有強取向,。

▲Figure 5 Pawley fit of the GID measurement from sample #2 using DIFFRAC.TOPAS.
IP-GID測量的分析(見圖6)是一致的:(002)峰具有非常低的強度,其他峰屬于垂直于(001)的不同晶格面,,表明多晶WS2膜沒有或很少有面內(nèi)擇優(yōu)取向,。垂直于表面的晶格常數(shù)比平行于表面的晶格常數(shù)大,,這表明薄膜內(nèi)部存在拉伸應變。然而,,由于只有幾個寬峰無法與WS2的六方晶系的大量hkl相擬合,,因此無法進行更詳細的分析。
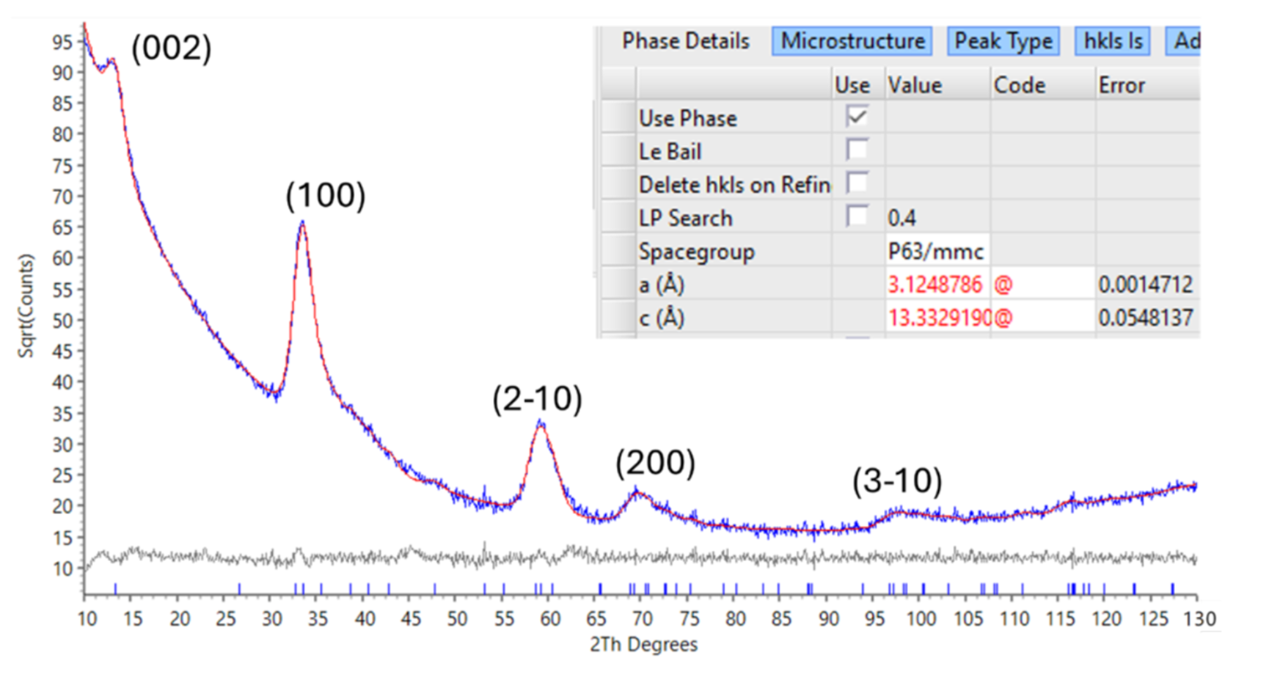
▲Figure 6 Pawley fit of the IP-GID measurement from sample#2 using DIFFRAC.TOPAS
歸納與總結(jié)
本申請報告報告了使用D8 DISCOVER Plus衍射儀對藍寶石襯底上具有超薄WS2薄膜的兩個市售樣品的研究,。采集XRR,、GID和IP-GID幾何數(shù)據(jù),并使用DIFFRAC.XRR XRR 和DIFFRAC.TOPAS進行分析,。
1)對于sample#1,,GID和IP-GID數(shù)據(jù)確認存在單個二維WS2薄膜。晶格參數(shù)為a=3.149 ?,,由XRR數(shù)據(jù)得到厚度為3.4 ?,。從WS2單層中獲得清晰的信號證明了IP-GID在薄膜分析中的出色性能。
2)對于sample#2,,XRR數(shù)據(jù)分析顯示膜厚度為169.7 ?,,對應于13層單層,c= 12.830 ?,。從GID和IP-GID數(shù)據(jù)中,,發(fā)現(xiàn)了明顯的垂直取向/織構,其c軸垂直于表面,。平行于表面和垂直于表面的各向異性晶格參數(shù)表明薄膜處于拉伸應變作用下,。
應用補充
對于單層單晶薄膜,IP-GID同樣具有不可忽視的重要性,。單層/多層單晶面內(nèi)測試速度遠快與多晶樣品,,實際中使用D8 DISCOVER Plus衍射儀單個掃描約幾十秒即可完成。建議2D材料結(jié)合使用IP-GID做為結(jié)構表征方式進行材料結(jié)構說明,。
-轉(zhuǎn)載于《布魯克X射線部門》公眾號
立即詢價
您提交后,,專屬客服將第一時間為您服務