請輸入產(chǎn)品關(guān)鍵字:
郵編:410011
聯(lián)系人:王治國
電話:0731-82222141
傳真:0731-82222302
手機(jī):0731-82222145
留言:發(fā)送留言
個性化:www.cschem.com.cn
網(wǎng)址:www.cschem.com.cn
商鋪:http://sorrent.com.cn/st7192/
HD-2700-日立球差校正掃描透射電子顯微鏡HD-2700
【產(chǎn)品簡介】
【詳細(xì)說明】
日立球差校正掃描透射電子顯微鏡HD-2700
產(chǎn)品介紹:
HD-2700是一款200kV的場發(fā)射球差校正掃描透射電鏡,。相比于普通的透射電鏡,HD-2700采用球差校正技術(shù),,大大減小了透鏡球差對分辨率的影響,,從而可以實現(xiàn)超高分辨率的觀察,。同時,HD-2700是目前少數(shù)以掃描透射(STEM)功能為主的透射電鏡,,大會聚角的STEM功能配合場發(fā)射電子槍和球差校正技術(shù)可以使HD-2700獲得亞納米級的電子束,,使得原子級分辨率的圖像觀察和元素分析成為了可能,大大提高了電鏡的觀察和分析能力,。
日立球差校正掃描透射電子顯微鏡HD-2700主要特點:
高分辨觀察
利用金顆粒保證0.144nm分辨率DF-STEM像(標(biāo)準(zhǔn)型),。
大束流分析
約為非校正的STEM探針電流的10倍,可以進(jìn)行高速,、高靈敏度能譜分析,,可以在更短的時間內(nèi)獲得元素的面分布圖,使得檢測微量元素成為可能,。
簡化的操作
提供了的GUI自動調(diào)節(jié)球差校正器
整體的解決方案
樣品桿與日立FIB兼容,,提供了納米尺度的整體解決方案,從制樣到數(shù)據(jù)獲得和zui終分析
多種評價和分析功能可選
可同時獲得和顯示SE&BF,、SE&DF,、BF&DF、DF/EDX和DF/EELS像,;可以配備ELV-2000型實時元素Mapping系統(tǒng)(DF-STEM像可以同時獲得),;可以同時觀察DF-STEM像和衍射像;可以配備超微柱頭樣品桿進(jìn)行三維分析(360度旋轉(zhuǎn))等,。
日立球差校正掃描透射電子顯微鏡HD-2700技術(shù)參數(shù):
| 項目 | 主要參數(shù) |
| 電子槍 | 冷場或熱場發(fā)射電子槍 |
| 加速電壓 | 200kV、120kV* |
| 0.144nm(標(biāo)準(zhǔn)型,,配有球差,、冷場或熱場) | |
| 線分辨率 | 0.136nm(高分辨型,配有球差,、冷場) |
| 0.204nm(標(biāo)準(zhǔn)型,,配有熱場,無球差) | |
| 放大倍率 | 200x - 10,000,000x |
| 圖像模式 | BF-STEM相襯度像(TE像),、DF-STEM原子序數(shù)襯度像(ZC像),、二次電子像(SE像)、電子衍射花樣(可選),、特征X射線像(可選:EDX),、EELS像(可選:ELV-2000) |
| 電子光學(xué) | 電子槍:冷場或熱場發(fā)射電子槍,內(nèi)置陽極加熱器 |
| 透鏡系統(tǒng):兩級聚光鏡,、物鏡,、投影鏡 | |
| 球差校正器:六極/傳輸 雙重(標(biāo)準(zhǔn)型和高分辨型) | |
| 掃描線圈:兩級電磁線圈 | |
| 電位移:±1μm | |
| 樣品桿 | 側(cè)插式,X=Y=±1mm,,Z=±0.4mm ,,T=±30°(單傾樣品桿) |
日立球差校正掃描透射電子顯微鏡HD-2700應(yīng)用領(lǐng)域:
HD-2700作為一款場發(fā)射球差校正的掃描透射電鏡,,不僅具有高分辨率的圖像觀察能力,同樣具有高空間分辨率的分析能力,,配合EELS和EDS可以實現(xiàn)原子級元素的分析,。HD-2700具有多種成像模式,可以滿足大部分樣品的觀察需求,,日立*的SE成像模式可以獲得透射電鏡無法獲得的樣品表面的信息,,同時又比普通掃描電鏡具有更高的分辨率,可以實現(xiàn)對樣品表面的高分辨觀察,。

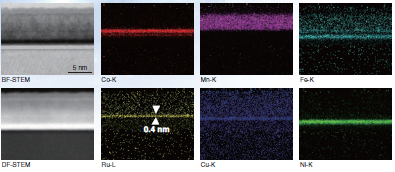
應(yīng)用文章:
[1] Ciston1, J., Brown2, H. G., D`Alfonso2, A. J., Koirala3, P., Ophus1, C., Lin3, Y., Suzuki4, Y., Inada5, H., Zhu6, Y. & Marks3, L. D. Surface determination through atomically resolved secondary electron imaging.Nature Communications,2005,6, 7358-7365.
[2] Zhu1*, Y., Inada2, H., Nakamura2, K. & Wall1, J. Imaging single atoms using secondary electrons with an aberration-corrected electron microscope.Nature Materials,2009,8, 808-812.


 QQ交談
QQ交談
