當(dāng)前位置:復(fù)納科學(xué)儀器(上海)有限公司>>公司動態(tài)>>復(fù)納科技云展臺搶先看,!相約上海 SEMICON China 2025
復(fù)納科技云展臺搶先看!相約上海 SEMICON China 2025

3 月 26 日 - 28 日,,SEMICON China 2025 將在上海新國際博覽中心盛大召開。
覆蓋設(shè)備,、材料,、設(shè)計、制造,、封裝測試,、軟件和服務(wù)等微電子、集成電路產(chǎn)業(yè)鏈各環(huán)節(jié)等產(chǎn)業(yè)鏈,,規(guī)模較大,、較具影響力的半導(dǎo)體專業(yè)展。來自各領(lǐng)域的專家學(xué)者,、產(chǎn)業(yè)鏈相關(guān)企業(yè)將齊聚一堂,,共赴這場半導(dǎo)體嘉年華,!
本次展覽會,飛納電鏡展位號 N2-2643,,歡迎大家到現(xiàn)場交流和互動,!飛納電鏡還準(zhǔn)備了免費(fèi)互動活動,歡迎蒞臨展臺交流,!

SEMICON CHINA 2025
會議時間:2025年3月26日-28日
會議地點:上海新國際博覽中心
展位號:N2-2643
SEMICON 2025 獲取觀眾注冊通道
復(fù)納科技云展臺搶先看
復(fù)納科技在電子半導(dǎo)體領(lǐng)域,從微納表征和樣品制備,、FIB 樣品精修,、到微納制造,具有豐富的產(chǎn)品線,,飛納電鏡 AFM-SEM 原子力掃描電鏡一體機(jī),、飛納清潔度檢測系統(tǒng) ParticleX,飛納場發(fā)射掃描電鏡,、表面拋光 / 截面切削制樣設(shè)備-氬離子研磨儀,、臺式納米 CT 等,可以滿足多樣化的材料檢測需求以及復(fù)雜的制程工藝管控,,實現(xiàn)缺陷和形貌觀察以及物性失效分析,。
識別下方二維碼進(jìn)入復(fù)納科技云展臺,查看復(fù)納科技半導(dǎo)體行業(yè)綜合解決方案,。

Part.1飛納臺式掃描電鏡
01 AFM-SEM 原子力掃描電鏡一體機(jī)
Phenom AFM-SEM 原子力掃描電鏡一體機(jī)能夠提供多種測量模式,包括機(jī)械性能,、相關(guān)性分析,、磁性能、電機(jī)械性能和電性能等,,覆蓋了從亞納米級地形測量到局部彈性,、硬度、磁疇成像,、壓電疇成像,、導(dǎo)電性映射、局部表面電勢映射以及局部電性能等多個領(lǐng)域,。

▌半導(dǎo)體材料-二硫化鉬(MoS)
02失效分析--飛納場發(fā)射掃描電鏡
失效分析是對于電子元器件的實效原因進(jìn)行診斷,這個過程中需要對失效位置的微觀形貌進(jìn)行檢測,,并進(jìn)行成分分析,。電子元器件的失效原因多樣,比如內(nèi)部存在雜質(zhì)、介在物,、孔洞,、腐蝕、開裂等,,這些都無法在后續(xù)的加工中去除,,反而容易引起造成更嚴(yán)重的破壞。因此,,需要借助掃描電鏡,,進(jìn)行快速判斷失效原因,,具有非常重要的意義,。
飛納臺式掃描電鏡分辨率優(yōu)于 1.0nm,15s 抽真空,,30s 超快成像,,可以快速過濾樣品,確認(rèn)分析位置和樣品前處理的狀況,。具有防震技術(shù),,可以放置在 FA 實驗室、高樓層辦公或者產(chǎn)線旁,。為您提供高效,、簡單、精確的半導(dǎo)體解決方案,,幫助您提升工藝良率,。

Part.2 掃描電鏡制樣-離子研磨儀
對于電子元器件進(jìn)行失效分析時,,對內(nèi)部的孔洞,、雜質(zhì)等進(jìn)行微觀結(jié)構(gòu)觀察和分析時,需要借助離子研磨儀切割的方法,,選擇合適的能量離子槍,,利于離子束進(jìn)行剖面的切削或表面拋光處理,可以有效地解決以上問題,。
MLCC 電容失效案例:

研磨前:無法確定 MLCC 燒結(jié)實際狀況,無法判斷失效原因離子研磨處理后:可以清晰看到 MLCC 介質(zhì)層存在孔洞等

結(jié)合能譜結(jié)果發(fā)現(xiàn) MLCC 介質(zhì)層還存在金屬氧化物
Part.3 FIB/TEM 制樣-離子精修儀
半導(dǎo)體行業(yè)需要使用透射電鏡(TEM)從原子尺度研究結(jié)構(gòu),、元素、價態(tài),、形貌對器件最終性能的影響,。借助聚焦離子術(shù)(FIB),工作人員可以制備器件某區(qū)域的薄片樣品,,用于 TEM 觀察分析,。但是,,F(xiàn)IB 制樣過程中鎵離子的注入以及所產(chǎn)生的非晶層,卻像一層難以驅(qū)散的迷霧,,阻礙著人們獲得更高質(zhì)量的微觀成像和譜學(xué)分析結(jié)果,。
Gentle Mill 離子精修儀配備設(shè)計的低能氬離子槍(100 - 2000 eV,連續(xù)可調(diào)),,可在比 FIB 更低的電壓下精修樣品,,從而大幅減少損傷層厚度,直至 1nm 以下,。該方法可對 FIB 樣品 / TEM 樣品進(jìn)行表面減薄,、表面后處理、去除非晶層和氧化層,,實現(xiàn)對樣品的表面清潔和最終精修,,展現(xiàn)樣品原始形貌結(jié)構(gòu),是改善 FIB 樣品的一種有效手段,。此外,,該設(shè)備還可以部分去除 TEM 觀察時在樣品表面產(chǎn)生的碳沉積,從而可以實現(xiàn)多次利用寶貴的 FIB 樣品的可能,。
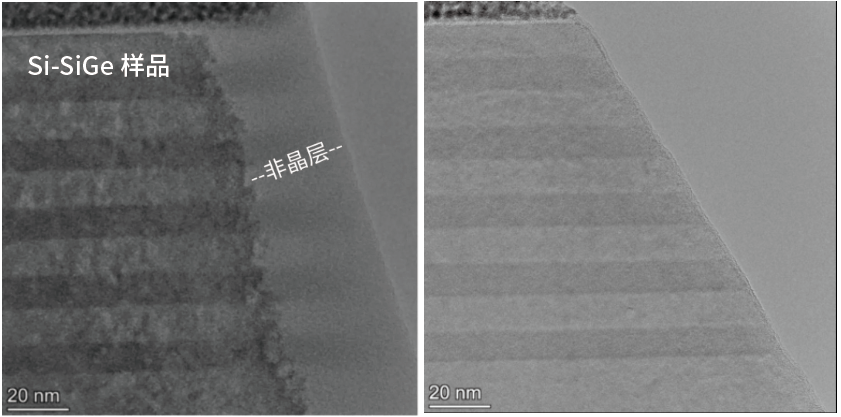
左圖為原始 FIB (30kV) 處理薄片;右圖為經(jīng)過 Gentle Mill (300 eV) 處理的薄片,。Si-SiGe 多層異質(zhì)結(jié)構(gòu)樣品兩側(cè)均使用 Gentle Mill 處理 2 分鐘,,以去除 FIB 薄片制備產(chǎn)生的非晶層。在 FIB 薄片的邊緣處可以看到非晶層厚度明顯減少,。
Part.4 NEOSCAN 臺式顯微 CT
顯微 CT 以其高分辨,、非破壞和三維成像的能力,被廣泛應(yīng)用于電子元器件領(lǐng)域,。在不影響設(shè)備完整性的前提下,,可以準(zhǔn)確識別和分析各種電子元器件,包括微型晶體管,、電容器,、電阻器等,可以發(fā)現(xiàn)內(nèi)部可能存在的缺陷,、焊接問題等,,從而確保設(shè)備的品質(zhì)和可靠性。
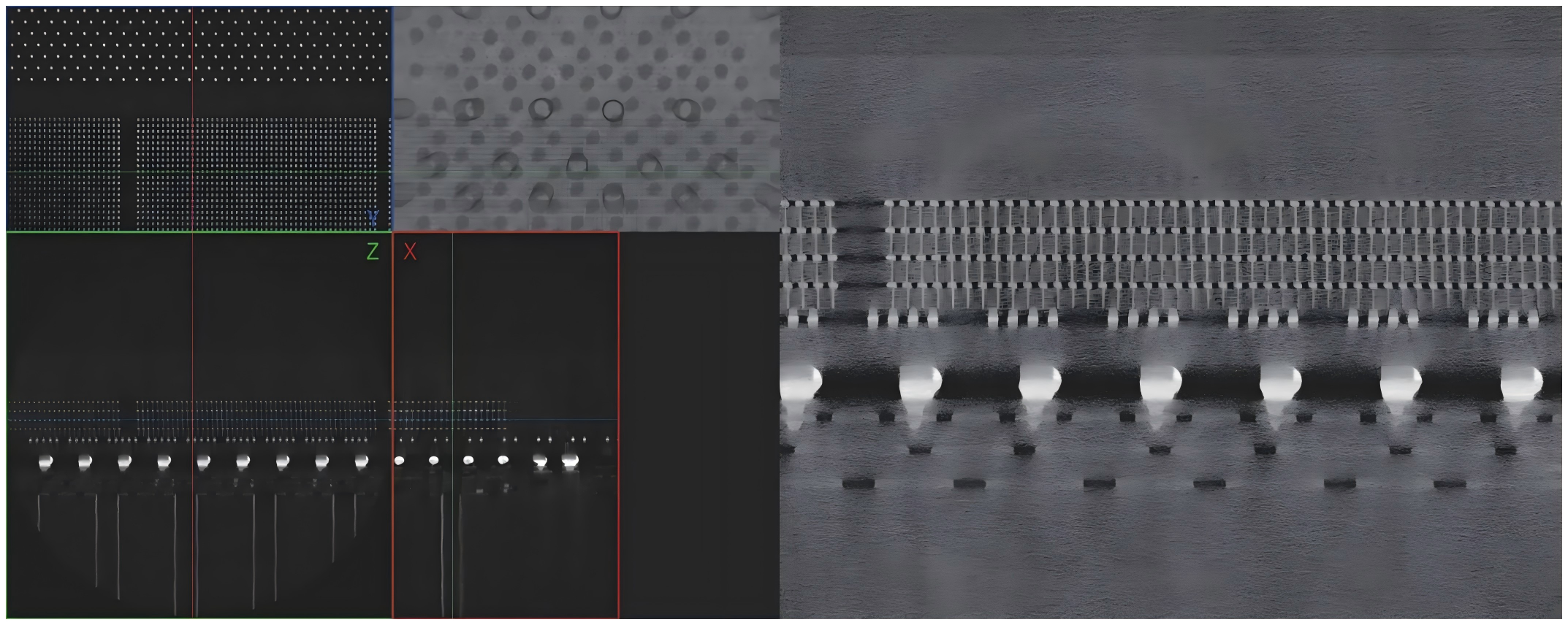
NEOSCAN N90 以 500nm 體素尺寸掃描高級 GPU,,輕松分辨每一個TSV(通硅孔)
Part.5 VSParticle 納米研究平臺
在半導(dǎo)體加工中,顆粒污染是不可避免的。部分顆粒發(fā)生器無法穩(wěn)定的產(chǎn)生納米級(尤其是 23nm 以下)的顆粒,,同時對于顆粒的組分限制較多,,部分方法含有液體,不利于顆粒污染的去除,。
VSParticle-P1 納米印刷沉積系統(tǒng)能夠?qū)崿F(xiàn)無機(jī)納米結(jié)構(gòu)材料的打印直寫,。印刷涂層的顆粒由火花燒蝕技術(shù)產(chǎn)生,氣溶膠顆粒典型粒徑在 20nm 以下,,且不含表面活性劑或任何其他有機(jī)添加物質(zhì),。借助 VSP-P1 納米印刷沉積系統(tǒng)沖壓沉積模式,可以在晶圓選定區(qū)域沉積圖案或顆粒,。同時搭載的納米粒子發(fā)生器可通過二次粒徑篩選,,并沉積到選定區(qū)域,選定粒徑的顆??梢赃M(jìn)行納米顆粒污染導(dǎo)致的失效模擬,,或研究區(qū)域的顆粒清除效果。
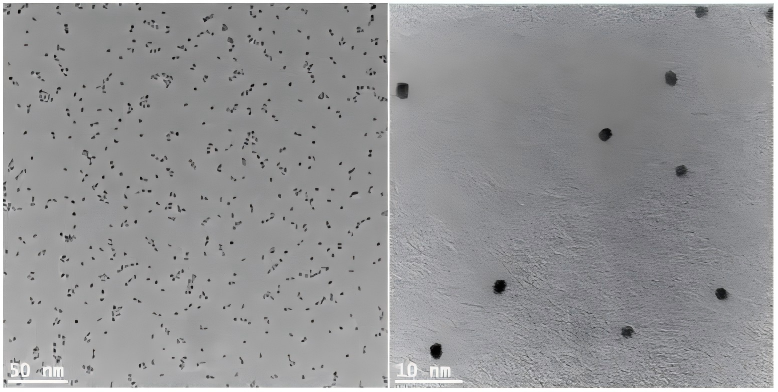
顆粒輸出精度:±0.5nm,1-10nm 顆??蛇x
Part.6 DEMSsolutions 原位樣品桿
在半導(dǎo)體器件生產(chǎn)過程中,,晶體生長過程、相變結(jié)構(gòu)演變,、器件性能測試,、環(huán)境條件影響這幾個方面都會影響到器件最終出廠后的實際性能表現(xiàn)。如何從微觀層面研究上述因素對器件結(jié)構(gòu),、性能的影響,,就顯得至關(guān)重要。
DENSsolutions 透射電鏡原位方案,,采用側(cè)插式樣品桿設(shè)計,、無需對電鏡做額外改裝、兼容市面上主流品牌透射電鏡,,從高溫,、低溫、電場,、氣氛等方面提供一系列的原位透射方案,,具體性能包括:分辨率 60 pm、最高溫度 1300 ℃,、低溫度 -160 ℃,、最大電場 300 kV/cm、最大氣壓 2Bar、兼容多種氣體,。借助 DENSsolutions 方案,,工作人員可以在高分辨觀察的同時,對材料,、器件施加多種外場刺激,,以研究晶體生長、結(jié)構(gòu)演變,、環(huán)境條件的對器件結(jié)構(gòu),、性能的影響。



 11
11
